北京适合游玩的公园排行榜(北京近郊免费公园大全)
2025-09-27 21:29:50
华为的“钻石芯片“专利,是什么?

布局芯片的未来
这两日,华为申请公布的一项专利引发关注。该专利由哈尔滨工业大学与华为技术有限公司联合申请,内容是 " 一种基于硅和金刚石的三维集成芯片的混合键合方法 "。自此公布至昨日,培育钻石概念涨超 16%。
许多人不禁疑惑,这项专利究竟指代的是什么?事实上,可以把这项专利关键词拆解,即 " 硅基与金刚石基衬底材料 "" 三维集成芯片 "" 混合键合 "。
钻石芯片,怎么造
比起钻石,更准确的说法应该是金刚石,据企查查专利查询显示,该专利主要应用在 " 硅基与金刚石基衬底材料 " 上,这一句的关键在于 " 衬底 "。

芯片是从晶圆上切下的来,晶圆的英文是 Wafer,与 " 威化 " 是同一单词,顾名思义,就像威化一样,是一层层组成的。晶圆可粗略地分为抛光片、外延片、SOI 片三大类,无论做成什么样的晶圆,其原点都是抛光片。
简单解释起来,抛光片是从硅柱切成薄薄一片,再抛光成质地平整的圆片,此时抛光片既可以直接经过光刻刻蚀制造芯片,也可以充当外延片和 SOI 片的 " 衬底 ";外延片就是在抛光片 " 外延 " 上再生长出一层的圆片;SOI 片就是在顶层和衬底之间引入氧化物绝缘埋层。
金刚石既可以用在衬底上,也可以用在外延上,也可以与其它材料混合使用,比如硅和金刚石。用人话解释就是把芯片的底层换掉,可能其中一两层材料是金刚石,也可能整个芯片大部分构成都是金刚石。
为什么要用金刚石造芯片?
这是因为金刚石就是个六边形战士,甚至可以称之为 " 终极半导体材料 ",造出来的芯片也天生更优秀。可以说,金刚石就是材料中的 " 天才 ",国内业界会称其为 " 第四代半导体 ",国外则主要用 " 超宽禁带半导体 " 的名字。具体来说,不同参数对应金刚石不同应用:
带隙达 5.5eV,使其更适合应用于高温、高辐射、高电压等极端环境下;
热导率达 22 W · cm-1 · K-1,可应用于高功率器件;
空穴迁移率为 4500cm2 · V-1 · s-1,电子迁移率为 3800cm2 · V-1 · s-1,高的载流子迁移率使其可应用于高速开关器件;
击穿场强为 13MV/cm,可应用于高压器件等;
金刚石激子束缚能达到 80meV,使其在室温下可实现高强度的自由激子发射(发光波长约 235nm),在制备大功率深紫外发光二极管和极紫外、深紫外、高能粒子探测器研制方面具有很大的潜力。
华为申请公开的专利文献中解释,金刚石是宽禁带半导体,具备击穿场强高、载流子迁移率高、抗辐照等优点,在热沉、大功率、高频器件、光学窗口、量子信息等领域具有极大应用潜力。
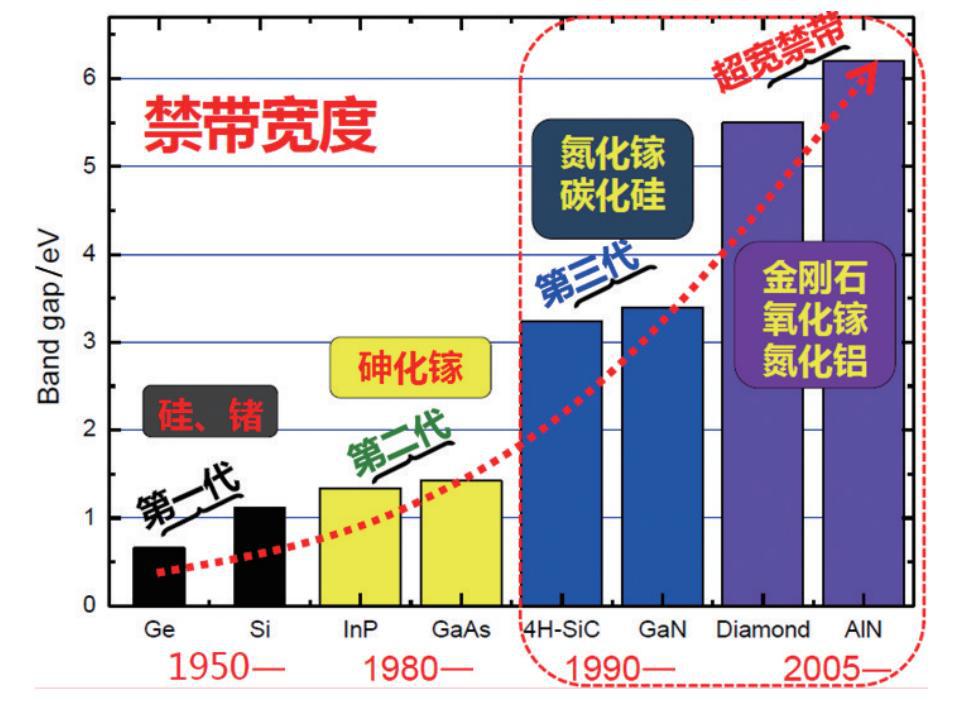
当然,需要注意的是,金刚石芯片虽然看起来美好,但目前还未形成大规模产业化,难点在于:
第一,并非所有金刚石都能造芯片,而是纯度极高的金刚石。金刚石分为量子级、电子级、光学级、热学级、力学级几个主要等级,主要参考位错密度和含氮量两个参数,用于芯片的金刚石需要在电子级以上。

第二,金刚石芯片掺杂存在瓶颈。纯净的金刚石本身是一种绝缘体,只有掺杂才能变成半导体。目前,金刚石芯片 p 型掺杂较为成熟,主要以硼(B)掺杂为主,而 n 型掺杂则是产业化的难题,n 型掺杂元素在金刚石中具有高电离能,很难找到合适的施主元素,目前学界和工业界众说纷纭,当然也逐渐有了进展。

第三,把金刚石做成芯片,再到器件本身已经研究了几十年,过程中产生了很多问题,也随着研究进程逐一解决。但目前,很多问题仅限研究领域,实际应用到业界必然会拥有更多问题,比如金刚石 FET 的设计和制造不同于标准器件、光掩模工艺存在诸多不便,都会是限制它大规模生产的问题。
第四,人造金刚石还很贵。碳化硅(SiC)价格是硅 30~40 倍,氮化镓(GaN)价格是硅的 650~1300 倍,而能造芯片的金刚石材料价格几乎是硅的 10000 倍。碳化硅和氮化镓之所以能大规模应用,是因为提升的效率与材料成本相抵消,甚至是更便宜了,金刚石芯片成本差距过大,应用到业界有点难。
不过,目前,美国和日本一直在推进金刚石芯片的产业化,包括美国阿克汉(Akhan)公司、英国元素六(Element Six)公司、日本 NTT 公司、日本产业技术综合研究所(AIST)、日本物质材料研究所(NIMS)、美国地球物理实验室卡耐基研究院、美国阿贡国家实验室,其中 Akhan 曾计划成为首个真正实现金刚石半导体产业化的公司。
可以说,谁先抢占先机,谁就是领先那个,所以全世界都在不遗余力发展。从过往专利来看,华为也非常关注金刚石发展,可见对于未来技术的关注。
芯片的升纬打击
" 三维集成芯片 "" 混合键合 " 其实对应着芯片行业的 "3D 封装和互连 "。
三维集成是什么?就像在三维空间上盖高楼,未来的芯片不会只局限在平面发展,而是会逐渐升高 " 纬度 ",就像做汉堡一样,不断叠高高,以增强性能。未来芯片也不会像现在一样,只是一颗单 CPU/MCU 芯片,而是集成加速器、内存、存储。
此前,英特尔研究院副总裁、英特尔中国研究院院长宋继强就曾在 2025 年的 WAIC 表示,异构封装是一个更小型的系统,将不同的计算能力整合在一起。由不同的 Die 整合起来的,所以能够利用不同架构芯片,在处理不同的数据、不同的任务的时候有独特的性能和功耗优势。
混合键合又是什么?我们把芯片拆成很多小芯片(Chiplet),那么把每个芯片封装到一起,粘合在一起就是是巨大的难题,如果粘起来间距很大,那必然影响最终芯片性能。而混合键合和 3D 封装是一对好搭档,它能够进一步缩小封装时裸片之间的凸点间距和功耗,这样封装技术可以让很多新的芯片很好地进行互连。
晶圆键合(Wafer Bonding)是近十几年快速发展起来的新兴半导体加工技术,在 MEMS,CIS 和存储芯片等领域有着重要的应用,通过界面材料,它分为带中间层的胶键合、共晶键合、金属热压键、无中间层的熔融键合和阳极键合等。而混合键合其英文是 Hybrid Bonding,顾名思义,是同时包含了熔融键合和金属键合的特点而得名。
从概念上来看,混合键合是指在一个键合步骤中同时键合电介质和金属键合焊盘。混合键合包括 wafer-to-wafer(W2W,晶圆到晶圆键合)和 die-to-wafer(D2W,芯片到晶圆键合)两种,前者更成熟,后者拥有更多工艺。
这两项技术都是未来突破芯片性能的关键,尤其在 1nm 以后进入 CFET 时代后,混合键合会是关键中的关键。
当然,概念远不止如此,混合键合工艺(包括电介质 PECVD、铜 ECD、CMP、等离子体激活、对准和键合以及分割)涉及严格的薄膜质量规范、高水平的清洁度及高测试覆盖率,实现难度极高,目前全世界的玩家少之又少,且工艺还未完全成熟,还在不断寻求进入产业的方法。更何况是用在金刚石芯片之中。
那么,在华为这项专利中, 三维集成和混合键合的重点在哪里?
专利文献显示,通过 Cu/SiO2 混合键合技术将硅基与金刚石基衬底材料进行三维集成能够融合硅基半导体器件成熟的工艺及产线、生产效率高、成本较低的优势及金刚石极高的发展潜力,为三维集成的硅基器件提供散热通道以提高器件的可靠性。然而,现有的 Cu/SiO2 混合键合技术多以硅为衬底进行集成,其集成工艺不完全适用于金刚石,存在以下问题:
(1)现有的 Cu/SiO2 混合键合样品的制备多采用标准大马士革工艺,即通过光刻显影刻蚀清洗种子层沉积电镀化学机械抛光 ( CMP ) 来完成样品制备,在此过程中 CMP 步骤必不可少,且是样品制备的关键。该步骤受抛光设备、抛光剂等硬件条件影响较大,且抛光完成后需专业设备进行后清洗,以防止因抛光剂残留导致键合强度下降。同时 CMP 过程中由于 Cu 与 SiO2 硬度差异较大,材料去除率不同导致 Cu 与 SiO2 间存在一定的高度差。过大的高度差会降低键合质量,影响上下芯片间电信号传播。而严格控制 Cu 与 SiO2 间高度差面临很大困难。标准大马士革工艺不适用于金刚石晶片表面 Cu/SiO2 混合键合样品的制备,同时 CMP 设备多针对 4 英寸以上晶圆级样品抛光,而大面积金刚石生产困难、成本极高。
(2)相比于硅基底,金刚石基底硬度大,金刚石晶片的表面抛光非常困难,将金刚石表面粗糙度抛光降低至 1nm 以内耗时极长且成本高,故而金刚石表面 Cu/SiO2 分布的表面粗糙度将随之上升,现有 Cu/SiO2 混合键合工艺,难以实现粗糙表面的金刚石三维集成,对于具备粗糙表面的硅 / 金刚石三维集成适用性较差。
(3)由于硅、金刚石材质差异大,高温键合工艺容易增大芯片间热失配,致使热应力增加,从而影响键合强度,不适用于硅 / 金刚石的三维异质集成。
而利用这项专利,就能够在硅基底及金刚石基底表面成功制备 Cu/SiO2 混合分布表面,且能够将制备的硅基和金刚石基 Cu/SiO2 样品进行混合键合,获得了良好的键合面积。

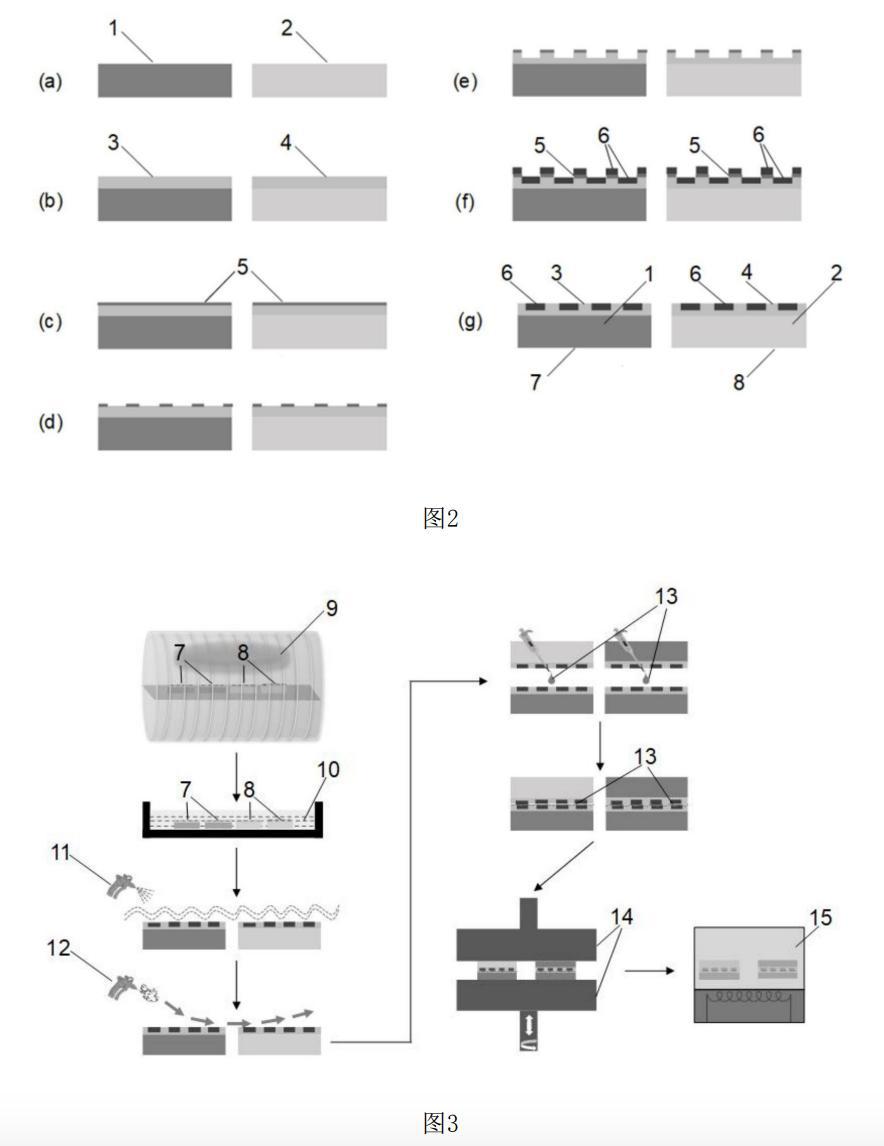
写在最后
纵观整个专利,华为将 " 未来 " 拉满,不仅包含终极半导体金刚石,也包括 3D 封装和混合键合,单独拿出哪一项技术,都还未产业化,但也都离大规模产业化只差一公里。
通过华为申请的历史专利也不难看出,华为非常关注这几个方向,或许这也是一种技术风向标,预示着未来,芯片技术的发展行径。
参考文献
[ 1 ] 王晨曦 ; 牛帆帆 ; 魏潇赟 ; 王敏才 ; 邓抄军 . 一种基于硅和金刚石的三维集成芯片的混合键合方法 .CN116960057A [ P ] .2025.10.27
[ 2 ] 郝跃 . 宽禁带与超宽禁带半导体器件新进展 [ J ] . 科技导报 , 2025, 37 ( 3 ) : 58-61; doi: 10.3981/j.issn.1000-7857.2025.03.008
[ 3 ] 李成明 , 任飞桐 , 邵思武 , 牟恋希 , 张钦睿 , 何健 , 郑宇亭 , 刘金龙 , 魏俊俊 , 陈良贤 , 吕反修 . 化学气相沉积 ( CVD ) 金刚石研究现状和发展趋势 [ J ] . 人工晶体学报 , 2025, 51 ( 5 ) : 759.https://www.opticsjournal.net/Articles/OJ2983cf7e567f6351/FullText
[ 4 ] 牛科研 , 张璇 , 崔博垚 , 马永健 , 唐文博 , 魏志鹏 , 张宝顺 . 单晶金刚石 p 型和 n 型掺杂的研究 [ J ] . 人工晶体学报 , 2025, 51 ( 5 ) : 841https://www.opticsjournal.net/Articles/OJ4fc3eb2b27781306/Abstract
[ 5 ] 半导体行业观察:混合键合,未来的主角 .2025.4.25. https://mp.weixin.qq.com/s/sTQIJS3xmKSJJv1Vq3P-jQ
2025-09-27 21:29:50
2025-09-27 21:27:34
2025-09-27 01:06:22
2025-09-27 01:04:06
2025-09-27 01:01:50
2025-09-27 00:59:34
2025-09-27 00:57:18
2025-09-27 00:55:02
2025-09-27 00:52:46
2025-09-27 00:50:31
2025-09-27 00:48:15
2025-09-27 00:45:59
2025-09-27 00:43:43
2025-09-27 00:41:27
2025-09-27 00:39:11
2025-09-27 00:36:55
2025-09-27 00:34:39
2025-09-27 00:32:23
2025-09-27 00:30:07
2025-09-27 00:27:51